单片机产业发展芯方向—3D芯片封装,单片机开发方案公司英锐恩分享芯资讯。集成电路业者开始探讨后摩尔定律时代下集成电路的发展芯方向,而3D芯片封装则是其中一个选择。包括英特尔、台积电、三星和一些OSAT厂都投入到3D芯片封装的研发当中去。
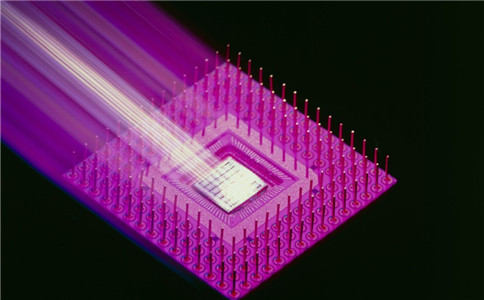
单片机芯片产业先进芯片封装技术正处于百家争鸣的时代,各单片机芯片厂商的先进芯片封装技术有着各自的特点。但是随着技术走向成熟、整合,芯片封装技术会逐步实现统一。
3D芯片封装号称是超越摩尔定律瓶颈的最大“杀手锏”,又称立体芯片封装技术,是在X-Y平台的二维芯片封装的基础上向z方向发展的高密度芯片封装技术。
与传统芯片封装相比,使用3D技术可缩短尺寸、减轻重量达40-50倍;在速度方面,3D技术节约的功率可使3D元件以每秒更快的转换速度运转而不增加能耗,寄生性电容和电感得以降低,同时,3D芯片封装也能更有效地利用硅片的有效区域。这种芯片封装在集成度、性能、功耗等方面更具优势,同时设计自由度更高,开发时间更短,是各芯片封装技术中最具发展前景的一种。
外卖出现之前,我们永远不知道泡面的竞争对手竟然不是同行。同样,这也适用于封测行业,台积电在摩尔定律发展的过程中,认识到后段芯片封装技术与前段制程发展不一致的问题,公司认为此时此刻不如自己打通任督二脉,利用自家在前段制程的研发经验来推动相关后段芯片封装的发展。于是,台积电推出了WLSI平台,该平台包括:CoWoS芯片封装、InFO芯片封装,以及针对PM-IC等较低端芯片的扇入型晶圆级芯片封装。
国内应继续加强在3D芯片封装技术方面的投入,研发重点向新兴技术转移,同时提高专利申请质量。
以上是单片机开发方案公司英锐恩分享的3D芯片封装芯资讯。